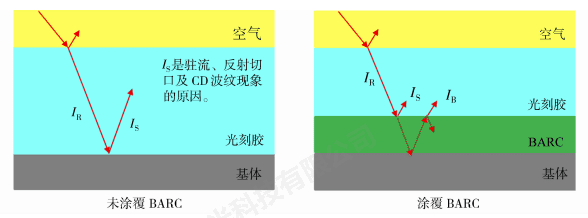
图1.有无底部抗反射层BARC效果对比
抗反射涂层量测意义及方案
抗反射涂层本质在于通过材料本身光学常数与厚度的共同作用来调节降低反射率。因此,在光刻工艺中,精确量测抗反射涂层(ARC)的光学常数(折射率n和消光系数k)与厚度有着至关重要的意义。
抗反射涂层的量测手段以光学测量技术为主:椭偏仪作为一种非接触、高精度的光学测量仪器,通过测量光经过样品前后的偏振态变化来计算薄膜的光学常数与膜厚均匀性;膜厚仪则通过测量光的干涉原理,从而快速、精确计算得到膜厚分布。
1.光学常数(n/k值)
抗反射涂层的光学常数决定了涂层可实现的理论反射率。椭偏仪能够快速、准确地获取全波段(如193–1650 nm)n/k 曲线,为工艺优化提供数据支撑。
2.膜厚与均匀性
抗反射涂层厚度的微小偏差会引发区域反射率不均,进而影响产品良率和性能一致性。椭偏仪通过二维平面Mapping扫描功能,可精确测量膜厚分布,从而有效保障工艺均匀性和稳定性。
3.多层结构解析
针对ARC+PR、Tri-layer等多层膜系,椭偏仪可通过分层建模,精确测量各层的厚度信息,解决膜层之间相互干扰的难题。
推荐产品
针对光刻领域,首要推荐颐光科技ME-Mapping自动扫描型椭偏仪,可以满足2-12寸晶圆的多点扫描测量需求,支持实时显示膜厚分布以及数据汇总。设备采用双旋转补偿器调制技术,结合精密的光路校准算法,直接测量16个全穆勒元素,可精确表征薄膜的膜厚、光学常数及介电函数等。

图2.ME-mapping
测量案例与数据分析
一、单点测量无机抗反射层SiON
1)对Si基底上SiON涂层进行建模测量,其结构示意图见图4。

图3.Si-SiON样品简化模型
Si-SiON的椭偏光谱拟合结果如图5所示。
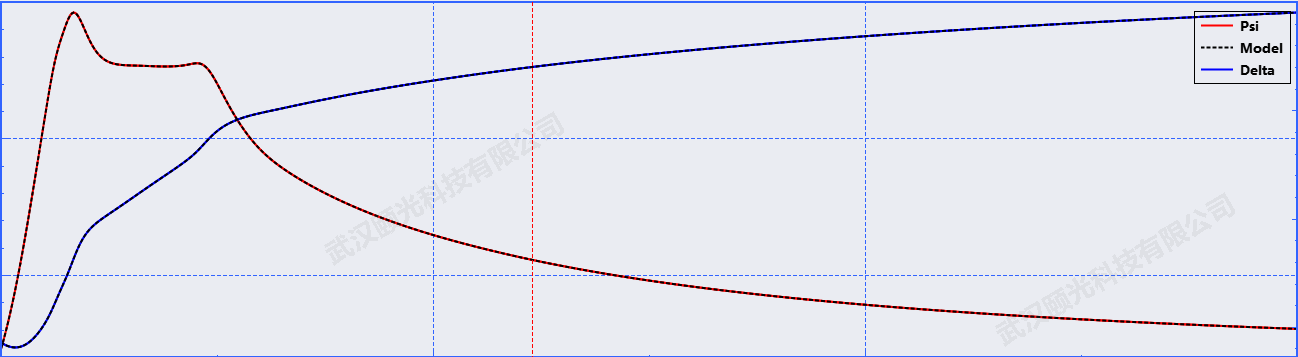
图4.Si-SiON的拟合结果
2)对Si-SiON-Resist涂层进行建模测量,其结构示意图见图6。

图5.Si-SiON-Resist样品简化模型
Si-SiON-Resist的椭偏光谱拟合结果如图7所示。

图6.Si-SiON-Resist的拟合结果
二、Mapping扫描测量BARC/BARC+PR
1)对Si基底上BARC涂层进行建模测量,其结构示意图见图8。

图7.Si基底上BARC样品简化模型
椭偏拟合光谱曲线如图9所示;同时,通过颐光科技的ME-mapping仪器测量可以准确反映出样件表面的厚度热力图,如图10所示,厚 度满足客户工艺预期。
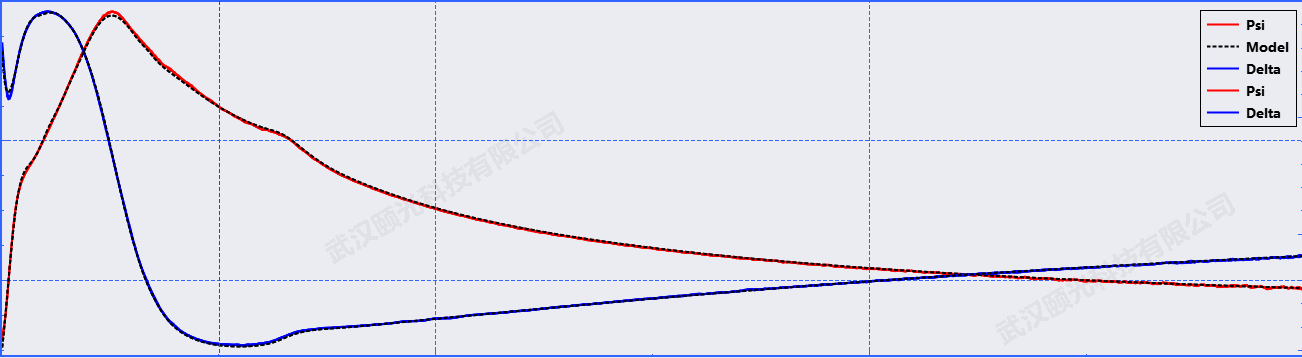
图8.BARC涂层样品椭偏仪拟合光谱

图9.BARC涂层的热力分布图
2)对BARC涂层上的光刻胶层进行建模测量,其结构示意图见图11。

图10.Si-BARC-PR样品简化模型
Si-BARC-PR的椭偏光谱拟合结果如图12所示。
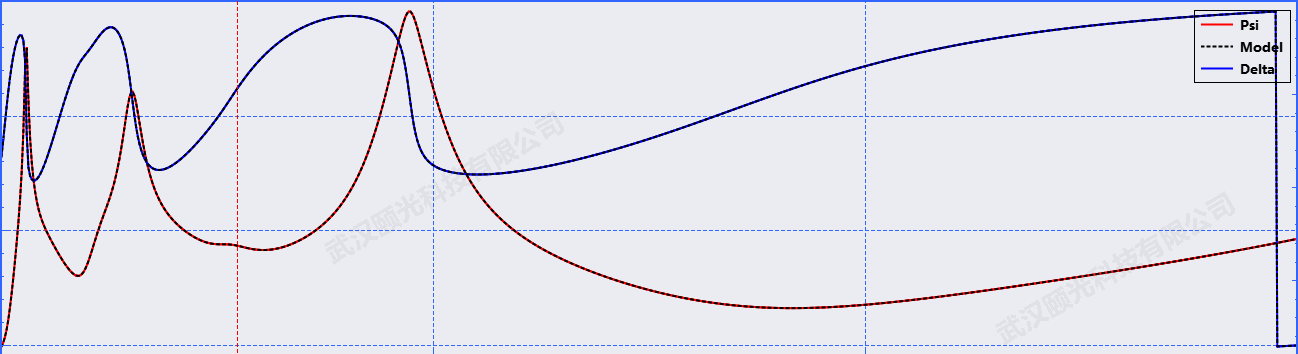
图11.Si-BARC-PR的椭偏仪拟合光谱
椭偏仪支持分析测量多层膜结构,图13为BARC+PR结构中BARC层厚度分布热力图,图14为涂覆光刻胶前后BARC层的厚度差异热力分布图。BARC层在涂覆光刻胶前后厚度差异小于0.5nm,符合客户工艺预期。图15为PR层厚度分布热力图,厚度均匀性符合客户工艺预期。

图12.BARC涂层的热力分布图

图13.涂覆光刻胶前后BARC涂层的厚度差异热力分布图

图14.光刻胶层的厚度热力分布图
Copyright©2026 武汉颐光科技有限公司 版权所有 备案号:鄂ICP备17018907号-2 sitemap.xml 技术支持:化工仪器网 管理登陆